半导体器件尺寸不断缩小和复杂度增加,纳米探针(Nanoprobing)技术成为解决微观电学问题和优化器件性能的重要工具,成为半导体失效分析流程中越来越重要的一环。

随着功率半导体的快速发展,其厂商也开始密切关注纳米探针技术在PN结特性分析和掺杂区域表征等应用领域。
以下将分享两个典型案例。
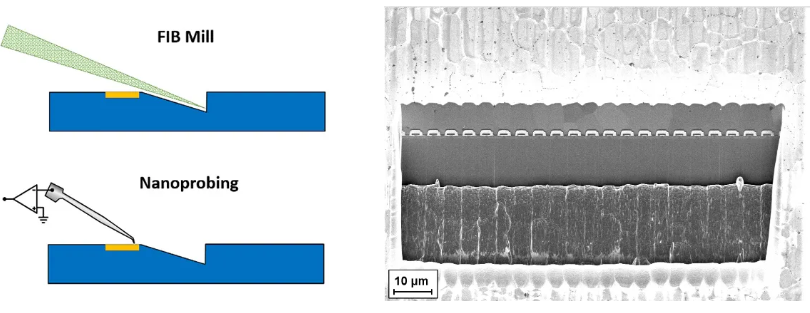
利用蔡司双束电镜Crossbeam系列(查看更多)的离子束在SiC MOSFET芯片上加工出一个坡面,把衬底和器件结构暴露出来,然后利用纳米探针和样品表面源极接触,在电子束扫描时收集EBIC信号。https://www.ameya360.com/hangye/111819.html
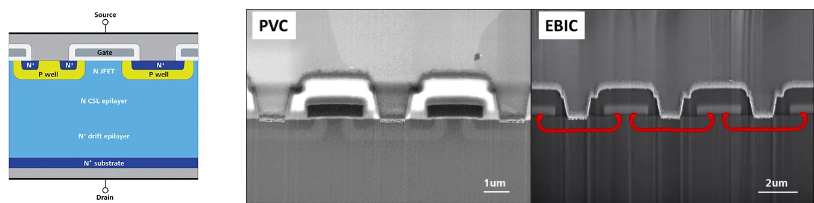
通过二次电子探测器我们得到中间的PVC图像,P well和N+区域有明显的衬度差异,可以表征离子注入区域。而右图中红色的EBIC信号显示了P well和N型外延层之间的边界,即耗尽层。
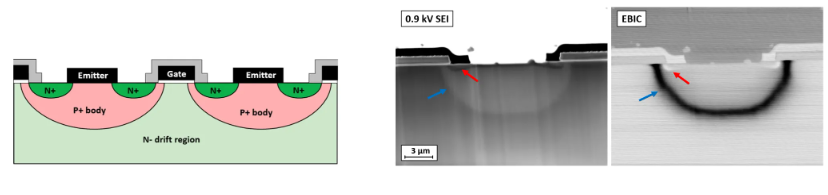
在另一种常见的功率器件硅基IGBT中,可以得到类似的结果。同样使用蔡司双束电镜Crossbeam系列完成样品制备,在二次电子图像中,N型和P型区域呈现出不同的衬度,而EBIC图像则是显示了各PN结的耗尽层位置,另外也可以看到轻掺杂形成的PN结耗尽层相对较宽。
灵活而高效的EBIC测试可以通过在蔡司场发射扫描电镜(查看更多)上搭载一到两支纳米探针,并配合信号放大器而实现,提供了一种除了扫描电容显微镜(SCM)和电压衬度(VC)成像以外的表征方法,帮助客户了解器件PN结特性和进行离子注入工艺相关失效分析。
*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。